均一性与稳定性控制
化学机械抛光(Chemical Mechanical Polishing,CMP)技术被誉为是当今时代能实现集成电路(IC)制造中晶圆表面平坦化的重要技术,CMP的效果直接影响到晶圆、芯片最终的质量和良率 。CMP是通过表面化学作用和机械研磨相结合的技术来实现晶圆表面平坦化。CMP过程中将Slurry(抛光液,也称抛光液)滴在晶圆表明,用抛光垫以一定的速度进行抛光,使得晶圆表面平坦化。
在CMP工艺中,对于Slurry而言,影响其抛光效率的因素有:Slurry的化学成分、浓度;磨粒的种类、大小、形状和浓度;Slurry的黏度、pH值、流速、流动途径等。 Slurry的磨料粒子通常为纳米或亚微米级别,粒径越小,表面积越大,表面能越大(或表面张力越大),越易团聚,而团聚而成的大颗粒会在晶圆表面产生划痕缺陷,直接影响产品良率。抛光液平均粒径越小,则对稳定性的控制挑战越大。
 |
奥法美嘉提供离线和在线两套方案用于解决CMP Slurry稳定性及均一性问题。离线方案使用HM&M珠磨机(小试和生产型)研磨分散制备Slurry,使用PSS(母公司:Entegris)Nicomp粒度仪系列和AccuSizer计数器系列对Slurry进行粒度检测,使用Lum系列稳定性分析仪对Slurry进行稳定性分析。在线解决方案中采用Entegris的浓度计和过滤器分别对工业生产中重复使用的Slurry进行浓度监测和除杂(过滤金属杂质及过大研磨颗粒)。采用PSS online 粒度检测设备进行在线粒度监测。 |
CMP流程概述
在 CMP 抛光液中,一般使用水基抛光液作为加工介质,以去离子水作为溶剂,加入磨料(如 SiO2、ZrO2 纳米粒子等)、分散剂、pH 调节剂以及氧化剂等组分,每个组分都具有相应的功能,对化学机械抛光过程起到不同的作用。珠磨机均质抛光液后经过过滤通过PSS的Nicomp粒度分析仪测试平均粒径、AccuSizer颗粒计数器测试过大颗粒浓度、Lum稳定性分析仪快速筛选抛光液配方稳定性,工业中还需采用Entegris的浓度计和过滤器分别对工业生产中重复使用的Slurry进行浓度监测和除杂(过滤金属杂质及过大研磨颗粒)。

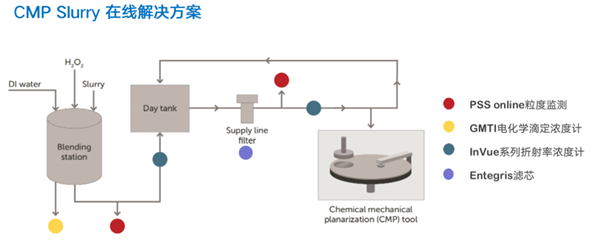
图1 CMP slurry离线及在线解决方案图示
抛光液磨料粒度控制
磨料的粒径大小、硬度、粒径分布均一性等因素对抛光研磨去除率起着重要作用。在对抛光液的磨料粒径进行考察时,主要评估其平均粒径大小,大颗粒、小颗粒浓度等指标。
HM&M珠磨机
HM&M珠磨机是通过研磨珠与物料的高剪切和高碰撞力将物料尺寸粒径磨小并更好的分散。通过不同的研磨珠子粒径、填充率及研磨频率可适用不同配方样品的研磨要求,从而快速达到要求的粒径。
|
⚫ 实验室研究工作用的珠磨机,50cc、100cc和150cc三种容量可供选择。(Apex Labo实验型) ⚫ 无筛网设计,没有物料堵塞风险,运行平稳,无累积压力,无压力损失。 ⚫ 可处理高粘度浆料 ⚫ 可使用最小15um,最大0.5mm研磨珠,一台设备满足大多数物料研磨和分散需求。 |
图2 HM&M APEX LABO(桌面实验型) 图3 HM&M生产型 |
平均粒径检测
CMP Slurry平均粒径的大小决定了整体抛光液的水平,用于确认是用于“粗抛”或“精抛”工序。在一定范围内,同类抛光液,在质量浓度相同的情况下,磨料的粒径越大,机械去除性能越好,但是由于磨料粒径的增加则同样质量下磨料颗粒的数量降低,抛光研磨效果只在一定范围内随粒径增加呈增长趋势 。一般而言,抛光液平均粒径大,则用于“粗抛”工序,平均粒径小,则用于“精抛”工序。
Nicomp纳米激光粒度仪系列
Nicomp系列纳米激光粒度仪采用动态光散射原理检测分析样品的粒度分布,基于多普勒电泳光散射原理检测ZETA电位。
|
⚫ 粒径检测范围0.3nm-10μm,ZETA电位检测范围为+/-500mV ⚫ 搭载Nicomp多峰算法,可以实时切换成多峰分布观察各部分的粒径。 ⚫ 高分辨率的纳米检测,Nicomp纳米激光粒度仪对于小于10nm的粒子仍然现实较好的分辨率和准确度。 |
图4 Nicomp 3000系列(实验室) 图5 PSS在线纳米粒度仪 |
尾端大粒子浓度检测
目前高端MLCC使用的钛酸钡粉体粒径极小,在80nm以下,粉体表面能较大,导致粉体的团聚形成大颗粒,陶瓷浆料中粉体分布不均匀,会造成壳层厚度不均匀 ,影响后续流延工艺和印刷工艺的效果。
AccuSizer颗粒计数器系列
AccuSizer系列在检测液体中颗粒数量的同时精确检测颗粒的粒度及粒度分布,通过搭配不同传感器、进样器,适配不同的样本的测试需求,能快速而准确地测量颗粒粒径以及颗粒数量/浓度。
|
⚫ 检测范围为0.5μm-400μm(可将下限拓展至0.15μm)。 ⚫ 0.01μm的超高分辨率,AccuSizer系列具有1024个数据通道,能反映复杂样品的细微差异,为研发及品控保驾护航。 ⚫ 灵敏度高达10PPT级别,即使只有微量的颗粒通过传感器,也可以精准检测出来。 ⚫ 可出具法规报告 |
图6 AccuSizer A7000系列 图7 PSS 在线颗粒计数器 |
稳定性分析检测
陶瓷浆料的稳定性影响其存放时间,陶瓷浆料是生产MLCC的第一个环节,再进行后续工艺,如流延、印刷,如果浆料稳定性较差,在进行上述工艺过程中发生了大量沉淀、团聚,陶瓷介质的紧密性和稳定性将会受到影响。在陶瓷浆料制备中,控制尾端大粒子数量以及对浆料进行分散能使陶瓷浆料更为稳定。
LUM稳定性分析仪
Lum稳定性分析仪可以直接测量整个样品的分散体的稳定性,检测和区分各种不稳定现象,如上浮、絮凝、聚集、聚结、沉降等,通过测量结果可用来开发新的配方和优化现有的配方及工艺。
|
⚫ 快速、直接测试稳定性,无需稀释,温度范围宽广 ⚫ 可同时测8个样品,测量及辨别不同的不稳定现象及不稳定性指数 ⚫ 加速离心,最高等效2300倍重力加速度 |
 |
过滤
过滤是在CMP Slurry制备及使用过程中都非常重要的一道工序,用于除去CMP Slurry中的杂质和尾端大颗粒。在实际应用中,过滤涉及的工况复杂多样,有在Facility阶段高浓度高流速、低浓度高流速的状态,也有在Point of Use阶段的低浓度低流速阶段,Entegris具有多年服务于半导体CMP工艺经验,提供不同状态的过滤方案。
Entegris-ANOW 滤芯
Entegris是一家为半导体和其他高科技工业提供加工和制造产品及材料的全球性开发商、制造商和供应商。对于半导体行业,Entegris的产品保持半导体生产过程中关键原料的纯度和完整性。
浓度计监控
在工业生产线中,Slurry是循环使用的,如果浓度过高或者过低均会影响最后抛光效果。化合物浓度的高低直接影响化学效应,研磨颗粒浓度高低则影响研磨效率及良率。因此,在线的CMP工艺还需对Slurry中的化合物浓度和研磨颗粒浓度进行监控,浓度过低时及时添加对应组分,浓度过高时及时稀释,这对浓度计的检测速度和准确度有一定要求,能够真实且快速地反映当前Slurry各组分的浓度计能有效把控CMP工艺的抛光效果。
Entegris浓度计
Entegris-Anow是一家高分子微孔膜过滤企业,专业从事MCE、Nylon、PES、PVDF、PTFE等(膜孔径为0.03μm~10μm)微孔膜的研发及生产,具有二十多年服务与医药客户经验,并为全球生物制药、医疗器械、食品饮料、实验室分析、微电子及工业等领域的客户提供过滤、分离和净化解决方案。Entegris旗下有两类浓度计用于CMP Slurry应用,一类是基于折射率变化原理的InVue浓度计,可用于实时检测H2O 2, Slurries, KOH浓度变化。另一类是基于滴定,氧化还原,离子吸附原理的SemiChem浓度计,可用于H2O2, H2SO4, HF 浓度监测。


图8 InVue® GV148 浓度监测仪 图9 SemiChem APM在线浓度计
|
|




















